中国正进入芯片高速发展期,光刻胶作为半导体制造不可或缺的材料,技术门槛高,而国内光刻胶整体技术水平远远落后国际先进水平,自给率较低,且集中在低端产品。该行业目前主要被美日企业把持,国内市场正面临“卡脖子”困局。此外,市场上制程稳定性高、工艺宽容度大且普适性强的光刻胶产品屈指可数,当半导体制造节点进入sub-100 nm,甚至是sub-10 nm,如何产生分辨率高且截面形貌优良、线边缘粗糙度(LER)低的光刻图形,成为光刻制造的共性主题。半导体市场持续扩大,如何进一步降本增效,也是大家共同努力的方向。而具备二元协同光响应机制的光刻胶有望为上述问题提供明确的方向,同时为EUV光刻胶的着力开发做技术储备。
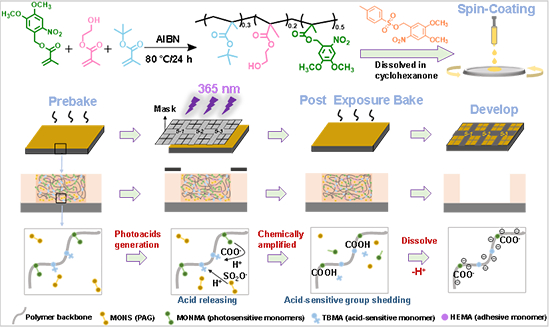
图1. 双非离子型光酸协同增强响应化学放大光刻胶的合成及其光刻工艺示意图。
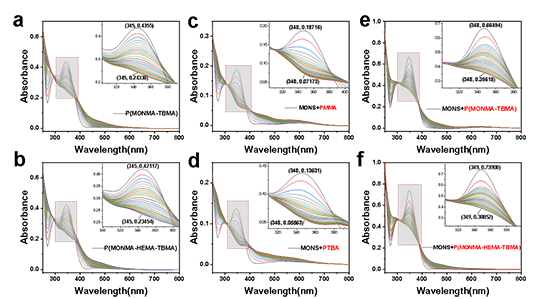
图2. 几种不同光刻胶体系在紫外光辐照下膜层的紫外吸收光谱动态变化:(a) P(MONMA-TBMA); (b) P(MONMA-HEMA-TBMA); (c) MONS/PMMA; (d) MONS/PTBMA; (e) MONS/P(MONMA-TBMA); (f) MONS/P(MONMA-HEMA-TBMA)。

图3.(a)光刻显影后P(MONMA-HEMA-TBMA)化学放大胶的光学显微镜效果图;(b)光刻胶十字图案表面形貌的扫描电镜图像;(c)光刻胶沟道图案表面形貌的扫描电镜图像;(d)光刻胶沟道图案宽度正态分布。
原文链接:https://doi.org/10.1016/j.cej.2024.148810
通讯作者简介

朱明强教授,2001年毕业于北京大学,获理学博士学位。现任职华中科技大学武汉光电国家研究中心教授。在JACS、Nano energy、Nat. Commun.与Adv. Mater.等国际顶刊上发表了100多篇论文,获2017年北京市自然科学二等奖和2023年湖北省自然科学二等奖,于2018年入选英国皇家化学学会会士。目前的研究重点集中于光刻制造、有机纳米光电子学和超分辨率成像。

柳俊教授,2014年毕业于香港城市大学,获理学博士学位。曾先后获湖北省“百人计划”,“3551光谷”,深圳市“海外高层人才孔雀计划”,深圳市龙岗区 “龙岗区高层次人才” 等人才称号。于2021年加入湖北九峰山实验室,任工艺中心主管。在Nanomaterials、ACS APM、Appl. Phys. Lett.和Solid-State Electronics等国际顶刊上发表多篇论文。目前主要负责化合物半导体的制造、加工和表征。

向诗力博士,2021年毕业于华中科技大学武汉光电国家实验室,获理学博士学位。在Nano energy、ACS APM、Chem. Eng. J. 与Chem. Mater.等国际顶刊上发表多篇论文。曾获“3551光谷优秀青年人才” 称号。2022年加入湖北九峰山实验室,目前主要负责半导体光刻制造的前端研发。
- 浙大伍广朋教授课题组 Angew:可水显影的高性能二氧化碳基化学放大光刻胶 2024-09-27
