13.5 nm波长的EUV光刻是半导体先进制程迈向sub - 7 nm节点的核心。但这一技术进步也为光刻胶带来了新的挑战:EUV光源的反射式光学镜组效率远低于DUV的折射式镜组,大幅降低的曝光亮度对光刻胶的灵敏度提出了更高的要求;雪上加霜的是,EUV难以被聚合物常见的C、N、O等元素吸收,需要强力的化学放大或敏化机制来提高EUV的利用效率;但随着光刻特征尺寸的缩小,化学放大机制的扩散特性与不均匀性、金属敏化团簇的尺寸分布与核-壳结构,又会带来不可忽视的随机缺陷。
因此学界普遍认为,实现理想光刻胶的关键在于设计一种同时具备高EUV吸收能力、高能量利用率、分子级构成基元且完全均一的材料体系:高EUV吸收与利用可以提高灵敏度、减少光子散粒噪声并限制反应体积;具备分子级构成基元且完全均一的材料体系则可以最大限度地避免组分随机分布、扩散以及材料基元尺寸带来的随机缺陷问题,从而达到兼顾灵敏度、分辨率和线边缘粗糙度(LER)的目的。然而,同时满足这四个要素的光刻胶至今仍未能见报道。
近日,清华大学化学系许华平教授课题组基于聚碲氧烷(Polytelluoxane, PTeO)开发出一种全新的光刻胶,满足了上述理想光刻胶的四大条件。在该项研究中,团队将高EUV吸收元素碲(Te)通过Te─O键直接引入高分子骨架中(图1A)。碲具有除惰性气体元素氙(Xe)、氡(Rn)和放射性元素砹(At)之外最高的EUV吸收截面,EUV吸收能力高于传统光刻胶中的短周期元素和Zn、Zr、Hf和Zn等金属元素,显著提升了光刻胶的EUV吸收效率(图1B)。同时,Te─O键较低的解离能使其在吸收EUV后可直接发生主链断裂,诱导溶解度变化,从而实现高灵敏度的正性显影(图1C)。这一光刻胶仅由单组份小分子聚合而成,在极简的设计下实现了理想光刻胶特性的整合,为构建下一代EUV光刻胶提供了清晰而可行的路径。相关成果以“Polytelluoxane as the ideal formulation for EUV photoresist”为题,于7月16日发表于《科学进展》(Science Advances)杂志。

图1. 聚碲氧烷作为EUV光刻胶理想配方的结构设计
实验显示,PTeO在13.1 mJ/cm2的EUV曝光剂量下即可分辨出最小线宽为18 nm、线边缘粗糙度(LER)为1.97 nm的图案(图2A),随机缺陷得到良好控制。在不同侧链结构调控下,PTeO亦展现出16 nm线宽、18 nm 半节距(Half Pitch)等多种高分辨图案能力,适用于稀疏与密集结构的兼容制备(图2B-D)。值得一提的是,该光刻胶无需后烘处理,合成工艺简洁,具有良好的工艺友好性和可拓展性。
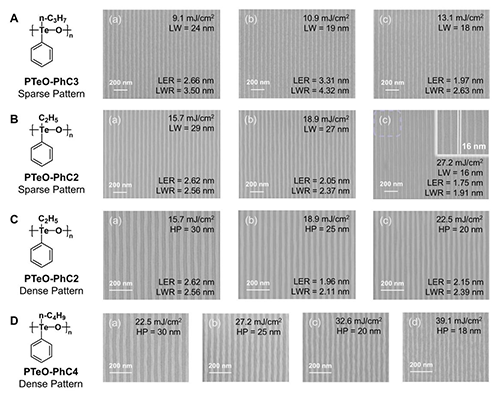
图2. PTeO的EUV光刻性能
此外,研究还通过电子束光刻(EBL,一种业内常用于替代EUV光刻的技术)研究了PTeO的光刻机理。通过凝胶渗透色谱、拉曼光谱、紫外可见光谱、质谱和核磁共振等表征手段,团队发现在曝光后Te-O主链发生了断裂,产生了极性更大、溶解度更高的小分子寡聚体(图3A-E)。由此作者提出了“主链断裂”的光刻机理,Te在吸收了EUV能量后产生高能二次电子,后者激发弱Te-O键断裂产生自由基,随后消除得到小分子寡聚体,从而诱导溶解度转变(图3F)。

图3. PTeO光刻机理研究
总而言之,凭借PTeO 独特的分子结构,团队成功实现了理想的光刻胶配方。高吸收性的Te元素通过弱Te-O键紧密集成到分子均质的聚合物体系中,通过主链断裂机制实现了出色的正性光刻性能。此外,与传统的化学放大胶(CAR)或金属氧化物胶(MOR)相比,PTeO 具有更简单的结构和合成方法,同时无需烘焙步骤,这些优势将有助于进一步验证这种新型光刻胶的适用性,并引领下一代光刻材料的设计策略。
清华大学化学系2024级博士生周睿豪为论文第一作者,2019级博士生曹木青参与了本工作。清华大学化学系许华平教授为通讯作者,清华大学集成电路学院马克·奈瑟(Mark Neisser)与江南大学化学与材料工程学院谭以正副教授为共同通讯作者。该研究得到国家自然科学基金重点项目的资助支持。
原文链接:https://www.science.org/doi/10.1126/sciadv.adx1918
- 浙大伍广朋、杭师大邱化玉 ACS Nano:兼具高稳定性和高灵敏度的极紫外和电子束倍半硅氧烷光刻胶 2025-10-31
- 中国科大刘世勇教授团队 Angew:基于精准高分子化学的单组分极紫外光刻胶 2024-09-29
- 浙大伍广朋教授课题组 Angew:可水显影的高性能二氧化碳基化学放大光刻胶 2024-09-27
- 华科大朱明强教授、湖北九峰山实验室柳俊教授/向诗力博士团队 ACS APM:再度发力光刻胶领域 2024-04-01
- 华科大朱明强教授联合湖北九峰山实验室柳俊教授/向诗力博士团队 CEJ:二元协同增强型化学放大胶助力半导体光刻制造 2024-02-22
